はじめに
2026年3月、マイポックスは12インチ(300mm)ウェーハに対応したCMP加工ラインを構築し、本格稼働を開始しました。
AI・デジタル社会の急速な進展や次世代モビリティの普及を背景に、半導体デバイスの高性能化と製造効率の向上に対する要求は年々高まっています。こうした市場ニーズに応えるべく、マイポックスは超精密研磨技術を基盤とした12インチCMP領域へ本格参入しました。さらに現在は「接合(ボンディング)工程」の設備拡充も並行して推進しており、研磨から接合までを一貫して担う「トータルファンドリーサービス」の確立を目指しています。
本記事では、マイポックスのCMP加工ラインが持つ独自の強みと、次世代半導体製造にもたらすビジネスメリットについて詳しく解説します。
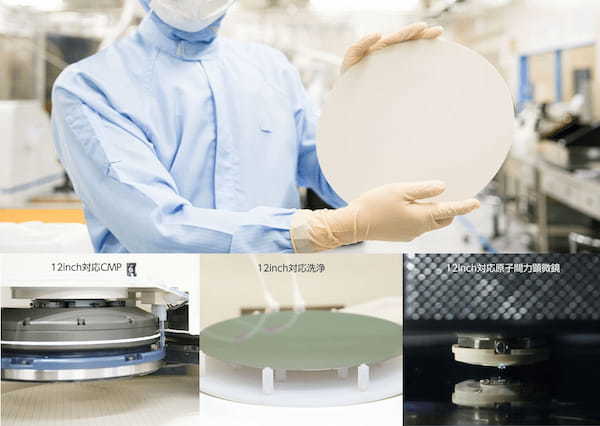
目次
CMPとは?ナノレベルの平坦化を実現する必須技術
CMP(Chemical Mechanical Planarization:化学機械平坦化)とは、研磨液(スラリー)と、パッドによる化学的、機械的作用を組み合わせ、ウェーハ表面を極限まで平坦にする研磨加工技術です。
従来の研磨技術では困難だった、異種材料が混在する表面の平坦化や、ナノオーダーの精度管理を可能にします。
先端ロジック半導体から次世代パワー半導体まで、CMP技術はあらゆる高性能デバイスの製造プロセスを支える根幹技術として位置づけられています。
12インチ化と3次元実装が突きつける「平坦化」の課題
AIや次世代モビリティの普及により、半導体にはさらなる小型化と高速化が求められています。その解決策として注目されるのが「3次元実装(TSV等)」ですが、ここでは従来のプロセスを凌駕する平坦度が要求されます。
1.接合エラーのリスク
表面にわずかな凹凸があるだけで、チップ積層時の接合強度が不足し、歩留まりが著しく低下します。
2.大口径化の難易度
12インチへの大口径化に伴い、ウェーハ外周部まで均一に研磨する制御技術が不可欠となっています。
マイポックス独自の優位性:「塗る・切る・磨く」の技術融合
マイポックスの最大の特徴は、「塗る」「切る」「磨く」という3つのコア技術を高度に融合させた点にあります。「研磨材(剤)開発製造」「機能性塗布」「精密研磨加工」の3事業を展開するメーカー系ファンドリーとして、他社にはない付加価値を提供します。
1.自社開発スラリーによる最適プロセス
研磨材メーカーとしての知見を活かし、特定の材料や目標精度に最適化したスラリーを自社開発。高度な平坦度と低ダメージの両立を、独自のCMPプロセスで実現します。
2.多様な先端材料への対応
Cu(銅)ダマシン案件をはじめ、接合用途向けの表面粗さ改善、各種機能性材料を用いたウェーハ製造案件など、極めて高度な平坦化技術を要するプロセスに幅広く対応します。
3.12インチSiCウェーハ受託研磨の開始
次世代パワー半導体として注目されるSiC(炭化ケイ素)は、EV・電力インフラ分野での需要拡大を背景に、12インチへの大口径化が急速に進んでいます。マイポックスは8インチSiCウェーハで培った独自の研磨加工実績をもとに、12インチSiCウェーハの受託研磨を開始。合理的な製造ソリューションを提供します。
| 項目 | マイポックスの12インチCMP | 一般的な受託加工 |
|---|---|---|
| プロセス最適化 | 自社開発カスタムスラリーで材料別に最適化 | 汎用スラリーによる標準的な加工 |
| 対応素材 | SiC・Cuなど各種先端材料 | シリコンがメイン |
| 一貫体制 | 研磨 ➔ 接合(ボンディング)まで一貫対応へ (2027年3月期中に確立予定) |
研磨のみ(工程間輸送が必要) |
今後の展望:接合工程の拡充と3次元実装への寄与
マイポックスは現在、CMP工程の次段階として、12インチ対応の接合(ボンディング)体制の構築を推進しています。
・体制確立予定:2027年3月期中
研磨から接合までの一貫体制により、TSV(シリコン貫通電極)を活用した次世代3次元実装への対応を可能にします。
この一貫体制が確立することで、工程間輸送による汚染・破損リスクの排除と、物流コスト・管理工数の大幅削減が実現します。
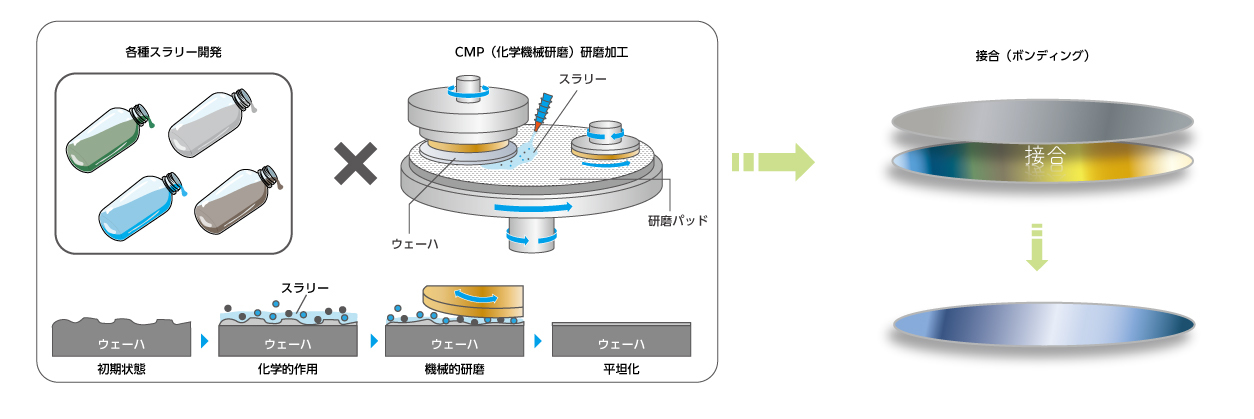
まとめ
マイポックスは、12インチ対応CMPラインの本格稼働により、最先端半導体製造の技術基盤をさらに強化しました。「塗る・切る・磨く」のコア技術を融合させ、単なる受託加工を超えたトータルファンドリーとして、SiC・Cu対応から将来の接合工程まで、お客様のイノベーションを一貫して支えます。
- CMP(化学機械平坦化):
- 研磨液による化学的作用と物理的研磨を組み合わせ、表面をナノレベルで平坦化する技術。
- TSV(シリコン貫通電極):
- シリコンウェーハを垂直に貫通する電極。チップ間の高速伝送・省電力化・小型化を実現する3次元実装のキーテクノロジー。
- SiC(炭化ケイ素):
- EV・電力インフラ向け次世代パワー半導体材料。高耐圧・低損失が特長で、12インチへの大口径化が進んでいる。
本件に関する詳細(ニュースリリース):
https://product.mipox.co.jp/news/20260312/
記事No,388
